SiC 功率器件封装解决方案
作者:伟邦材料 发布时间:2020-08-06 10:48 浏览次数 :
Die Top System(DTS)一种适用于SiC功率半导体器件封装的材料系统,也是目前适用范围最广,无IP限制,可在结温200℃及以上环境中使用的新型材料。
半导体材料性能比较
半导体材料
带隙(eV)
熔点(K)
主要应用
第一代半导体材料
硅Si
1.11
1687
低压,低频,中频,功率晶体管
第二代半导体材料
砷化镓GaAs
1.4
1511
微波,毫米波器件,发光器件
第三代半导体材料
碳化硅SiC
3.05
2826
高温,高频,抗辐射、大功率器件
氮化镓GaN
3.4
1973
高频,抗辐射,蓝、绿、紫发光二极管,激光器
表格1:来源自网络分享
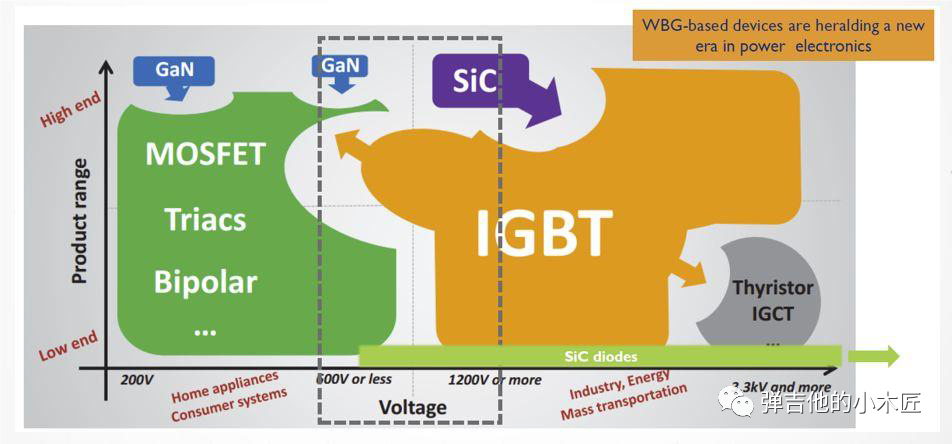
图片1:来源自网络分享
虽然Si 材料的器件在整个市场依然拥有90% 以上的市场份额,但是随着终端应用技术的拓展在一些如新能源汽车、轨道交通、智能电网等关键领域,SiC 取代传统的Si 是必然趋势。Si 器件工作温度大多在150 ℃,通常最高不会超过185℃,但是SiC 器件在性能提升的同时, 其工作温度也达到了近200℃甚至更高,这对SiC 器件的封装材料及工艺技术提出了更高的要求。
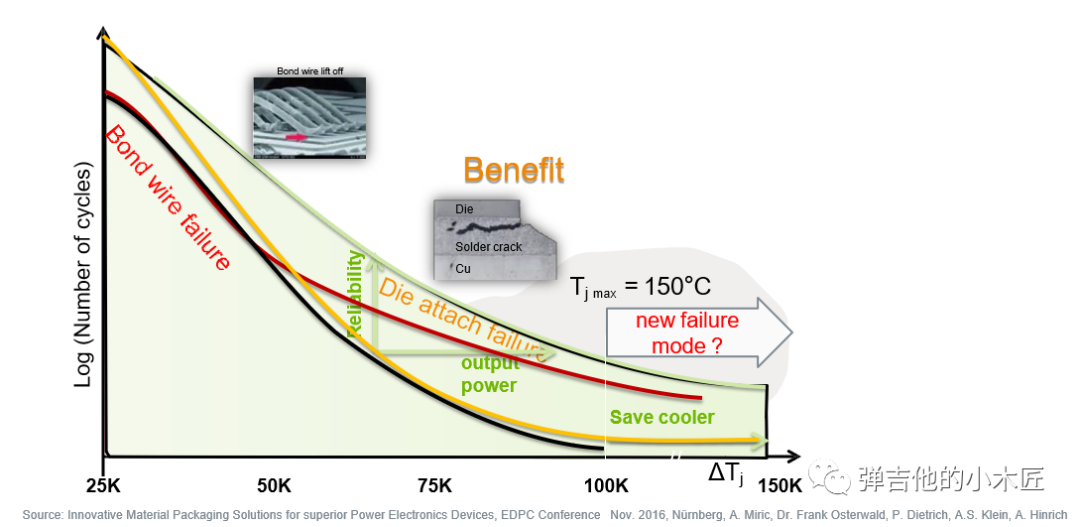
图片2:来源自网络分享
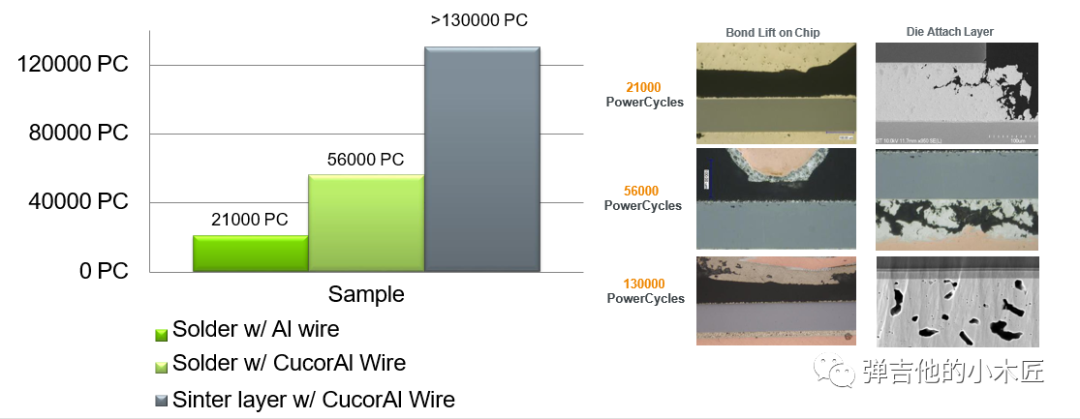
图片3:来源自贺利氏
|
特性 |
单位 |
铝 |
铜 |
|
熔点 |
℃ |
660 |
1084 |
|
热导率 |
W/(m·K) |
230 |
399 |
|
线性膨胀系数 |
ppm/K |
23 |
17 |
|
导电率 |
A/(V·m) |
37.7x106 |
59.1x106 |
|
抗拉强度 |
MPa |
40-50 |
200-300 |
|
弹性模量 |
GPa |
70 |
100-300 |
|
维氏硬度 |
Mpa |
167 |
369 |
|
密度 |
g/cm3 |
2.7 |
8.96 |
表格2:来源自网络收集
|
特性 |
单位 |
合金焊料 |
烧结银 |
|
元素 |
- |
有铅或无铅 |
无铅 |
|
熔化温度 |
℃ |
290 - 310 |
961 |
|
加工温度 |
℃ |
360 - 400 |
230 |
|
热导率 |
W/mK |
<50 |
>200 |
|
导电率 |
MΩ/cm |
0.01 - 0.03 |
≤0.01 MΩ/cm |
|
热膨胀系数 |
ppm/K |
25 - 30 |
15 - 19 |
表格3:来源自网络收集
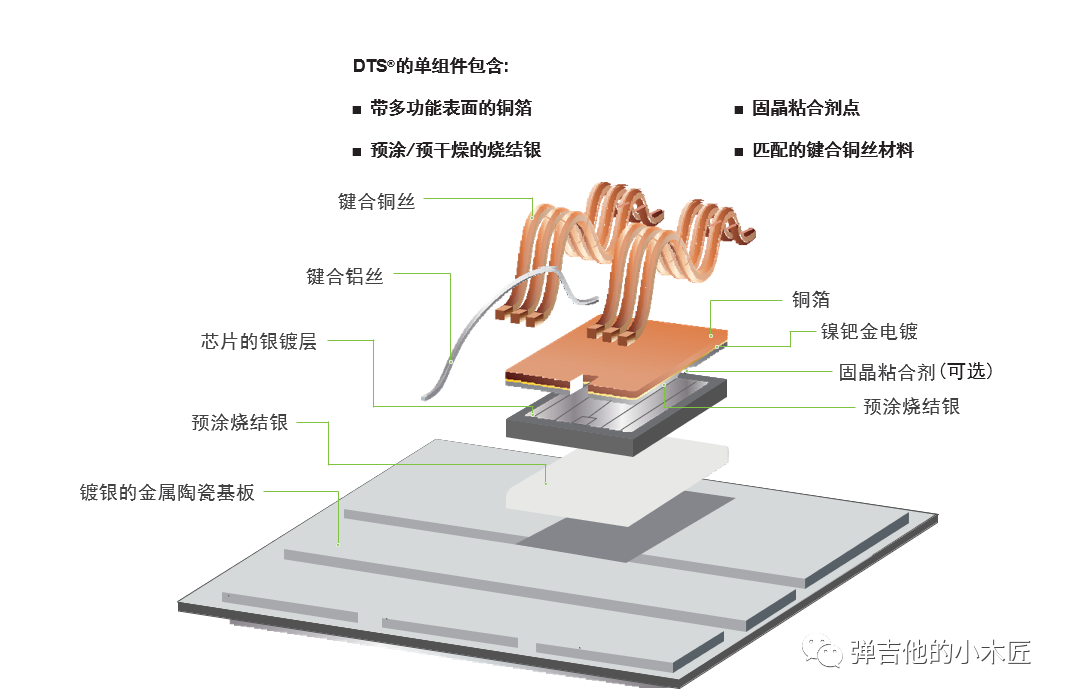
图片4:来源自贺利氏

图片6:来源自贺利氏
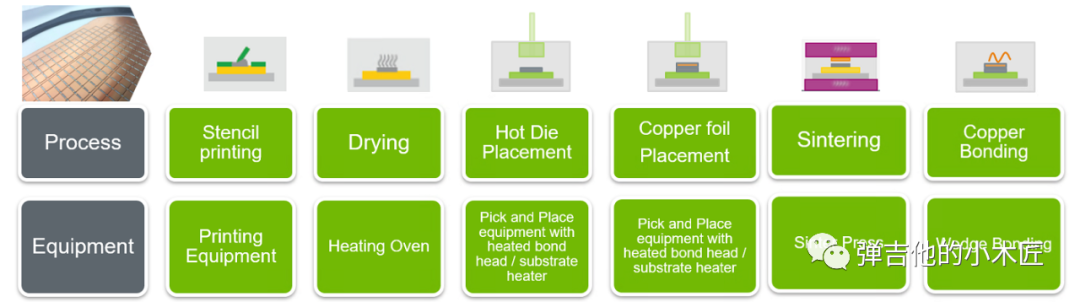
图片7:来源自贺利氏
