解决AI芯片散热难题:导热材料如何助力?
发布日期:2024-10-14 14:21 浏览次数:
随着人工智能技术的飞速发展,AI芯片成为推动高性能计算的核心引擎。从训练复杂的神经网络到执行大规模的并行计算,AI芯片承担着极高的运算负荷。然而,伴随高计算密度而来的,是大量的热量产生。若不能及时有效地散热,不仅会导致芯片过热,甚至可能影响到AI系统的整体性能与稳定性。因此,如何通过先进的导热材料和散热技术为AI芯片“降温”,成为当前产业关注的焦点。
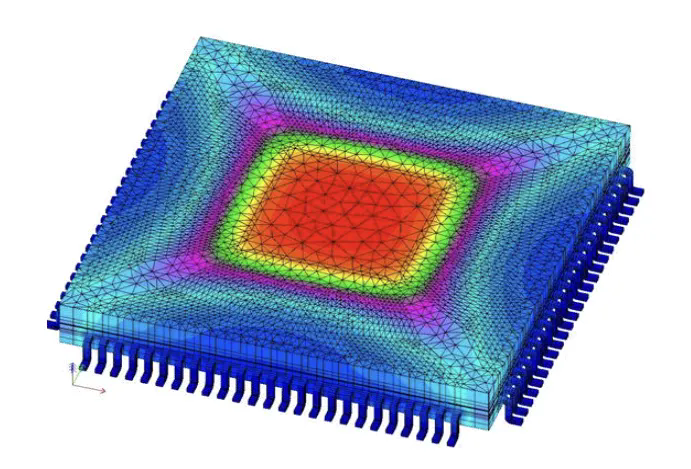
芯片的温度云图变化
一、AI芯片的散热难题根源
散热不良会对AI芯片性能和寿命的影响,如降低频率、限流等。目前,AI芯片的散热难题主要源于以下几个关键原因:
01 高功率密度
AI芯片在执行复杂的计算任务时,需要极高的功率,这导致其单位面积内的功率密度大大高于传统处理器。更高的功率密度意味着更多的热量集中在更小的区域内,散热难度增加。尤其是用于深度学习、推理和训练模型的AI芯片(如GPU和TPU),其功耗和发热量比普通CPU高得多。
比如说目前主流应用的NVIDIA A100 Tensor Core GPU就是专为AI和高性能计算设计,具有400W的最大功耗;专为高性能计算和AI推理任务设计AMD Instinct MI200加速卡,功耗接近500W。而今年,服务器制造商戴尔透露了NVIDIA即将推出的人工智能(AI)GPU,代号为Blackwell,功耗高达1000W,比上一代芯片的功耗足足增加了40%。面对这样高的功率,必须要配套高效散热解决方案。

02 芯片封装设计的限制
随着芯片集成度的提升,现代AI芯片包含了数十亿个晶体管,尺寸越来越小,且设计上紧凑。这种高度集成的封装设计导致芯片内部的热量无法迅速有效地传导至外部进行散热。封装材料的导热性能有限,进一步加剧了热量积累。
03 工作负载的连续性
AI芯片通常需要长时间持续工作,例如用于实时数据分析或训练复杂的人工智能模型。这种连续性工作负载意味着芯片持续产生大量热量,且散热的时间窗口非常有限。传统的散热解决方案难以应对这样长时间、高强度的工作负荷。
二、AI芯片散热技术
散热技术通过直接在芯片或处理器表面移除热量来优化设备性能并延长使用寿命。随着AI芯片的计算能力不断提升,其功耗和热量也随之增加,传统的散热方案逐渐暴露出局限性。为了确保AI芯片能够长时间高效运作,行业开始寻求更先进的散热技术和材料创新。以下将分为散热材料以及散热技术两部分总结。
散热材料
01 热界面材料(TIM)
在AI硬件中,由于器件制造公差和表面粗糙度的存在,器件之间通常会有微小的空隙。这些空隙含有空气,而空气是热的不良导体,常温下导热系数仅为0.026W/(m·K)。因此,导热界面材料(TIM)被用来填补这些空隙,排出空气,提供更好的热传导路径,降低界面热阻,从而提升散热效率。
以AI终端设备中的高功耗芯片为例,通常通过倒扣焊工艺实现散热,芯片的热量沿“芯片-TIM-封装-TIM-散热器”路径传导至外部。根据材料放置位置,TIM分为TIM1和TIM2两种类型。
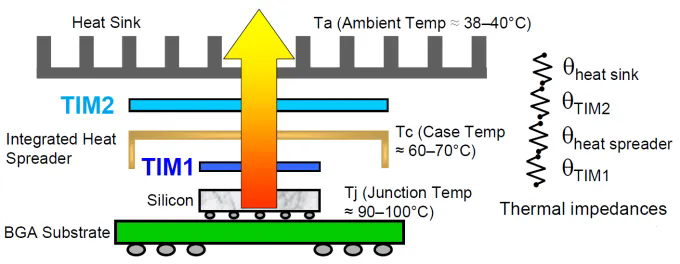
TIM1/ TIM2 结构(来源:硬件起源)
TIM1型材料用于芯片封装内部,位于发热芯片/管芯与散热金属盖之间。TIM1直接接触热源,要求具备极高的导热性能和电绝缘性,确保芯片有效散热并避免短路。此外,由于芯片与金属盖的热膨胀系数不同,TIM1还需具备合适的热膨胀系数。主流TIM1材料通常由高导热性粉体填充含硅或非硅聚合物制成,常见形态包括导热膏、导热胶等。在一些高端PC的CPU中时而采用具有良好传热性能的相变材料等作为顶部连接材料。
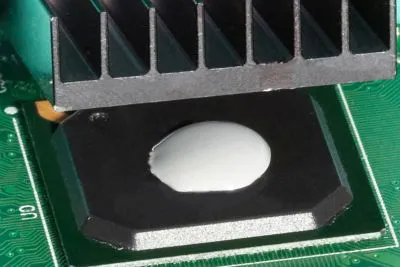
TIM2型材料用于封装外部,位于散热器和封装之间。相较于TIM1,TIM2已远离芯片,工作环境温和,导热性能要求相对较低,且无需电绝缘性。但它仍需有效传导热量,确保散热。TIM2材料通常为碳基复合材料,且多为可分离设计,便于热沉在系统级组装过程中拆装。
02 金属和陶瓷基导热材料
金属导热材料(如铜、铝等)因其优异的导热性,常用于极端环境下的芯片散热。金属的高导热系数(如铜的导热系数约为400 W/(m·K))使其能够快速将热量从发热源传递出去,适合高热通量应用场景。同时,金属材料具备较高的机械强度和抗热冲击能力,广泛应用于需要在恶劣环境下持续高效散热的AI芯片中。
陶瓷导热材料(如氮化铝、氮化硅)不仅具有良好的导热性,还具备电绝缘性,是许多AI芯片封装和高功率应用中的理想选择。陶瓷材料的导热性介于金属和传统聚合物材料之间,且其热稳定性使其能够在高温或腐蚀环境下使用。例如,氮化铝的导热系数高达170-180 W/(m·K),广泛用于极端环境下的AI芯片封装中。
散热技术
散热技术包括风扇、液冷、热管、VC均热板等,这些技术如何适用于AI芯片散热,但面临的局限性。
01 风扇
风扇散热是将冷空气吹过散热器或直接吹向芯片表面,进而将芯片产生的热量转移到空气中。
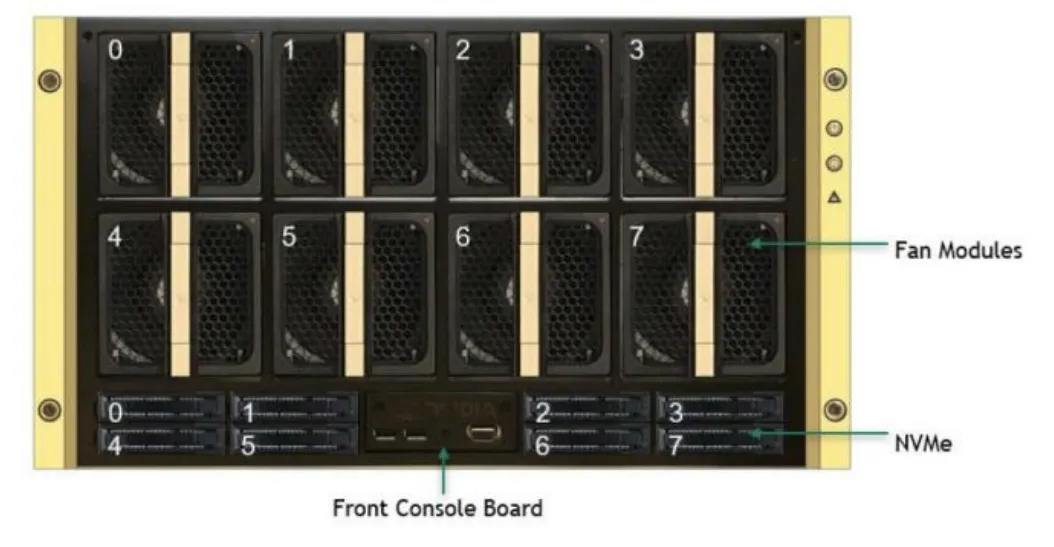
服务器风扇
优点:风扇散热系统设计简单,成本较低,安装方便,且应用广泛。风扇作为风冷散热器的两大重要部件之一,其性能对服务器散热效果和使用寿命具一定决定性作用,也可以与热管/3DVC/冷管等组合使用。
局限性:风冷的散热效率受限于空气的热导率较低,在高负荷和密集运算的AI芯片中效果有限。
02 液冷
液冷技术通过将液体(如水或冷却液)作为传热介质,利用其高热容量和高导热性,将AI芯片产生的热量迅速带走。液冷系统通常由冷却液管路、冷板或散热片、泵和散热器组成,冷却液吸收热量后被送到散热器,再通过空气或水冷的方式散热。
优点:液冷相较于风冷具有更高的散热效率,因此常用于数据中心和高性能计算(HPC)中,比风冷更适合支持高功率AI芯片持续工作。
局限性:液冷系统复杂且成本较高,安装和维护要求较高。此外,若系统出现泄漏,可能导致设备损坏。此外,液冷系统的物理空间占用较大。
03 热管
热管技术通过相变原理进行高效导热。热管内部包含导热液体,液体在靠近热源的部分吸收热量蒸发成气体,气体沿热管移动到冷端释放热量并凝结成液体,液体再通过毛细作用或重力回到热源端循环。这种循环使得热管能够迅速传导热量。
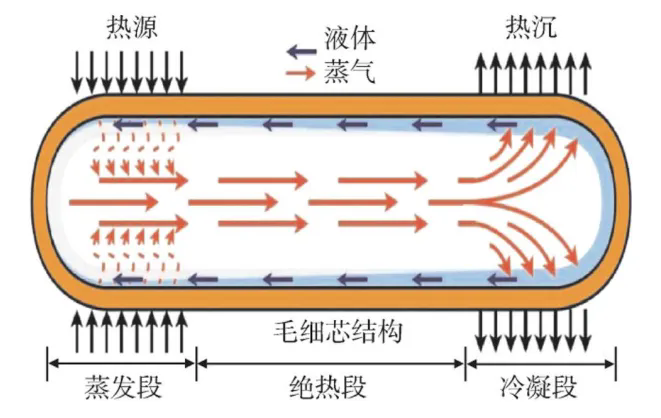
热管的工作原理
优点:热管具有极高的导热效率,且体积较小,重量轻,适合应用于空间受限的设备中。
局限性:尽管热管导热效率高,但其散热能力受到热管数量和设计的限制,主要用于中等功耗或空间受限的场景,难以在超高功率芯片中单独使用。
04 VC均热板
在热管的结构基础上,二维均温技术(VC均热板)、三维的一体式均温技术(3D VC均热板)被逐渐被开发。均热板与热管的原理相似,都是让冷却液吸收热源的能量,然后经过蒸发(吸热)、冷凝(放热)的相变过程,将热量分散导向外部。
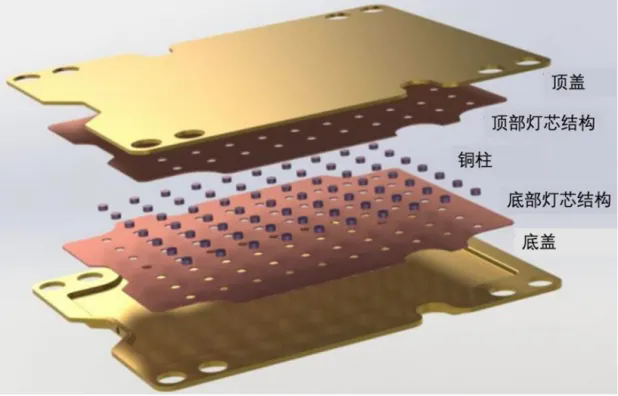
华为Mate60采用的VC均热板
优点:均热板可设计成任意形状以适应不同的热源布局,以二维甚至三维方式帮助器件散热,接触面积更大,散热更均匀,相比热管,传热效率提高了20% - 30%。同时其紧凑的设计也更利于安装在小型化设备中。
局限性:VC均热板的制造成本相对较高,尤其是在复杂三维结构的设计和制作上。此外,均热板的散热能力在极高功率密度下可能依然存在限制,难以单独应对某些高热负载场景,通常需要与其他散热技术结合使用。
三、总结
导热材料与散热设计在AI芯片的性能表现中起到了至关重要的作用。高效的散热系统不仅能够维持芯片的稳定运行,还能防止过热对其计算能力、能效和寿命的负面影响,尤其是在高负载的场景如边缘计算和5G基站中,散热设计的优劣直接影响整体系统的运行效率。
随着AI产业的快速发展,AI芯片的功耗与热管理需求也将持续增长。因此,未来在导热材料和散热技术领域的持续研发投入是必不可少的。通过不断创新与优化,散热解决方案才能够满足AI芯片在更大规模、更高性能场景中的应用需求,推动AI产业迈向新的高度。
上一篇:芯片,太热了!
